Schadens- und Fehleranalyse von Leiterplatten
Funktionellere, kleinere und dünnere Endgeräte – wie z. B. Smartphones – erfordern kleinere und dichtere Leiterplatten und elektronische Komponenten. In der Automobilindustrie haben automatische Brems- und autonome Fahrtechnologien die computergestützte Steuerung vorangetrieben. Daher steigt die Nachfrage nach zuverlässigen Leiterplatten und einer genauen und schnellen Qualitätsverbesserung mittels Schadens- und Fehleranalyse.
In diesem Abschnitt werden aktuelle Anwendungsbeispiele für Schadens- und Fehleranalyse von Leiterplatten mit dem Digitalmikroskop von KEYENCE vorgestellt.

- Bedeutung der Schadensanalyse von Leiterplatten
- Methoden der Schadens- und Fehleranalyse von Leiterplatten
- Aktuelle Beispiele für die Betrachtung und Analyse von Leiterplatten
- Verbesserte Genauigkeit und Arbeitseffizienz bei der Schadens- und Fehleranalyse von Leiterplatten
Bedeutung der Schadensanalyse von Leiterplatten
Elektrische Geräte, wie Smartphones, Tablets und tragbare Geräte sind in den letzten Jahren beständig kleiner, dünner und funktionaler geworden. Aus diesem Grund werden auch die verwendeten Leiterplatten und Bauteile kleiner, dichter und mit mehr Schichten konzipiert. In der Automobilindustrie hat die Entwicklung von Technologien wie automatisches Bremsen und autonomes Fahren die computergestützte Steuerung wichtiger Komponenten vorangetrieben. Bei einer solchen Steuerung wird von den Leiterplatten und elektronischen Komponenten eine hohe Haltbarkeit und Zuverlässigkeit erwartet, damit sie der Dauerbelastung durch Fahren, Beschleunigen und Anhalten standhalten.
Terminals und Geräte spielen heute in verschiedenen Alltagssituationen eine wichtige Rolle, und Autos erfordern ein hohes Maß an Sicherheit. Ausfälle und Defekte von wichtigen Komponenten, die in solchen Produkten computergesteuert sind, können zu ernsthaften Störungen oder Unfällen führen.
Um die Haltbarkeit und Zuverlässigkeit von Leiterplatten und elektronischen Bauteilen zu bewerten, haben Tests zur Zuverlässigkeitsbewertung, einschließlich Beschleunigungstests, zunehmend an Bedeutung gewonnen. Zusätzlich zu solchen Tests an Produkten wird aus Sicht der Qualitätssicherung die Ursachenermittlung und Qualitätsverbesserung durch die Schadens- und Fehleranalyse von Leiterplatten mit Mikroskopen als wichtiger denn je erachtet und erfordert daher eine höhere Genauigkeit.
In diesem Abschnitt werden Methoden der Schadens- und Fehleranalyse von Leiterplatten für Probleme wie unsachgemäße Montage und Defekte elektronischer Komponenten, die während der Herstellung oder nach der Lieferung verursacht wurden, erläutert.
Methoden der Schadens- und Fehleranalyse von Leiterplatten
Für die Schadens- und Fehleranalyse von Leiterplatten stehen folgende Methoden zur Verfügung.
- Erkennen von Fehlerstellen
- Fehlerstellen werden z. B. durch die Lock-in-Thermographie identifiziert, die den Fehler elektrisch nachbildet, um erhitzte Bereiche zu erkennen, die durch Kurzschlüsse oder Undichtigkeiten elektronischer Komponenten und Geräte verursacht werden.
- Verstehen der Fehlerstellen
- Um die physikalischen Eigenschaften mikroskopischer Strukturen richtig zu verstehen, werden diese mit einem Röntgentransmissionsmikroskop, einem CT-Scanner, einem Elektronensonden-Mikroanalysator (EPMA) oder anderen Geräten betrachtet.
- Betrachten und Analysieren von fehlerhaften Bereichen (Fehleranalyse)
- Um spezifische Ursachen zu identifizieren, werden Defekte durch Querschnittsbetrachtung der fehlerhaften Bereiche genau analysiert, wofür Werkzeuge wie Mikroskope, Rasterelektronenmikroskope (REM), FIB-Mikroskope (Focused Ion Beam) und EPMAs verwendet werden. Alternativ kann die Betrachtung in der Ebene erfolgen, was beispielsweise bei polierten Oberflächen und geöffneten Kunststoffverpackungen angewendet wird.
Aktuelle Beispiele für die Betrachtung und Analyse von Leiterplatten
Bei der im vorigen Abschnitt vorgestellten Schadens- und Fehleranalyse von Leiterplatten ist eine präzise Betrachtung und Analyse von fehlerhaften Bereichen besonders wichtig. Um die Ursache von Fehlern zu ermitteln, die bei Produkten im Handel oder bei Tests zur Zuverlässigkeitsbewertung gefunden werden, müssen Analyse und Bewertung genau und schnell sein.
Bei einer solchen Analyse und Bewertung werden häufig Mikroskope eingesetzt, um das Erscheinungsbild der fehlerhaften Bereiche zu überprüfen.
Das Digitalmikroskop der Modellreihe VHX von KEYENCE verwendet modernste Technologien, wie beispielsweise hochauflösende Objektive und einen 4K-CMOS-Sensor und ermöglicht so die genaue Betrachtung und Analyse von fehlerhaften Bereichen mit scharfen Aufnahmen. Die Modellreihe VHX unterstützt auch 2D- und 3D-Messungen auf einfache Weise mit hochauflösenden vergrößerten Aufnahmen. Solche Messungen tragen zu einer präzisen und schnellen Durchführung der für die Analyse erforderlichen Aufgaben bei.
In diesem Abschnitt werden die aktuellsten Beispiele für die Betrachtung und Analyse mit der Modellreihe VHX vorgestellt.
Betrachtung und Analyse des Drahtbondens
Das Digitalmikroskop der Modellreihe VHX verfügt über ein System zur Betrachtung aus jedem beliebigen Winkel, das selbst eine Betrachtung aus der Schräge ermöglicht. Zudem bietet es eine integrierte LED-Durchlichtbeleuchtung, eine Funktion zur Glanzlichtentfernung, welche die Blendung durch spiegelnde Oberflächen reduziert und eine Tiefenzusammensetzung in Echtzeit, die das Objekt vollständig fokussiert. Dank all dieser Funktionen können Anwender das dreidimensionale Drahtbonden auf tiefenscharfen, hochauflösenden Aufnahmen auch bei hoher Vergrößerung korrekt betrachten und analysieren.
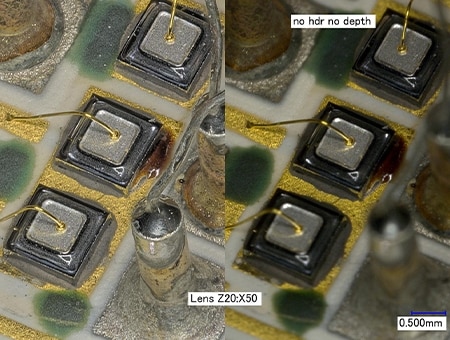
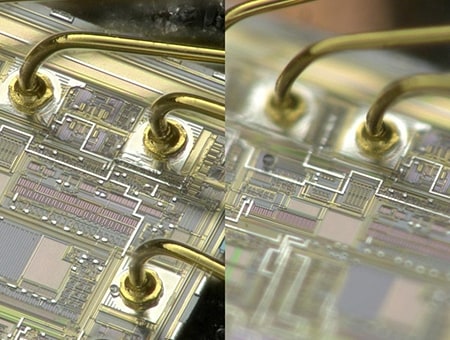
rechts: ohne Tiefenzusammensetzung (200x)
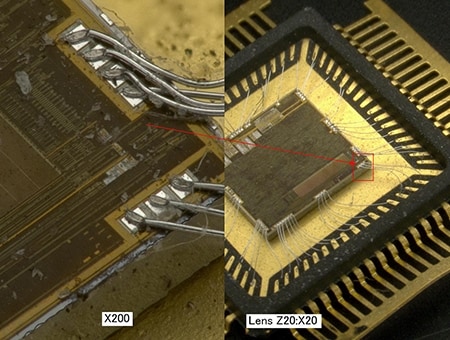
(links: 200x / rechts: 20x)
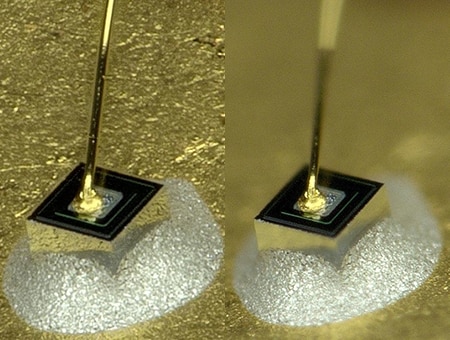
rechts: ohne Tiefenzusammensetzung
Betrachtung und Analyse von Querschnitten und Oberflächen von Halbleitergehäusen
Das Digitalmikroskop der Modellreihe VHX verfügt über vielseitige Beleuchtungsoptionen, einschließlich Hell- und Dunkelfeld, Differential-Interferenz-Kontrast und polarisiertes Licht. Damit lassen sich die Eigenschaften von Klebern und Pasten, die für das Halbleiter-Packaging verwendet werden, sowie die Formen der Materialien betrachten.
Selbst wenn der Objektquerschnitt einer in Kunststoff eingebetteten Probe Unregelmäßigkeiten aufgrund von unsachgemäßem Schneiden oder Polieren aufweist, kann die Oberfläche mit einer begrenzten Anzahl von Aufnahmen dreidimensional dargestellt werden, so dass der Anwender auch bei hoher Vergrößerung ein tiefenscharfes Bild erhält.

/ unten: Hellfeldbeleuchtung (100x und 300x)
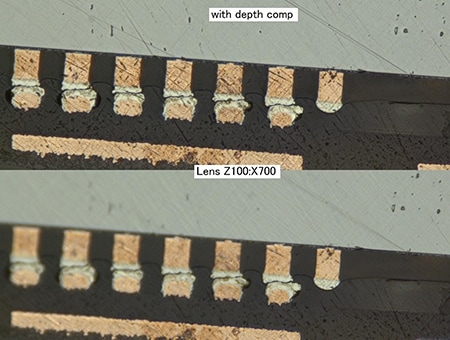
unten: ohne Tiefenzusammensetzung (700x)
Mit dem eigens entwickelten System zur Betrachtung aus jedem beliebigen Winkel der Modellreihe VHX können Gehäuseoberflächen und Pins bei hoher Vergrößerung aus jedem Winkel betrachtet werden. Die hohe Tiefenschärfe ermöglicht eine schnelle und präzise Analyse mit tiefenscharfen Aufnahmen, wodurch aufwendige Einstellungen überflüssig werden.



Betrachtung, Messung, und Analyse von Leiterplatten
Die hochauflösenden Objektive und der motorisierte Revolver des Digitalmikroskops der Modellreihe VHX ermöglichen eine nahtlose Zoomfunktion, die automatisch die Vergrößerung zwischen 20x und 6000x wechselt. Mit dieser Funktion lassen sich Zoom- und Betrachtungsfunktionen mit intuitiver Bedienung durchführen. Mit dem System zur Betrachtung aus jedem beliebigen Winkel können auch bei der stark vergrößerten Betrachtung aus der Schräge tiefenscharfe, hochauflösende Aufnahmen aufgenommen werden. Dadurch können dreidimensionale Montagekomponenten klar betrachtet und analysiert werden. Bilder mit unterschiedlichen Vergrößerungen können mit der Split-Screen-Funktion nebeneinander angezeigt werden, so dass der Anwender auch bei dichten Leiterplatten immer den zu analysierenden fehlerhaften Bestückungsbereich im Blick hat.
Darüber hinaus können 3D-Form- und Profilmessungen im Submikrometerbereich direkt auf einem hochauflösenden Bild mithilfe der Höheninformationen durchgeführt werden, sodass der Anwender eine quantitative Analyse und Auswertung mit nur einem System vornehmen kann.


Endkontrolle der Qualitätsmerkmale von IC-Chips
Das Digitalmikroskop der Modellreihe VHX unterstützt hohe Vergrößerungen bis zu 6000x und ermöglicht so die Aufnahme von hochauflösenden Bildern. Mit der Tiefenzusammensetzung und der HDR-Funktion können Objekte mit unebenen Oberflächen unter verschiedenen Beleuchtungsbedingungen vollständig fokussiert werden, so dass der Anwender selbst feine Kratzer auf IC-Chip-Schaltungsmustern erfassen kann.
Neben der Schadens- und Fehleranalyse von Leiterplatten können schnelle und genaue Analysen und Auswertungen bei der Endkontrolle der Qualitätsmerkmale am Fertigungsstandort durchgeführt werden.
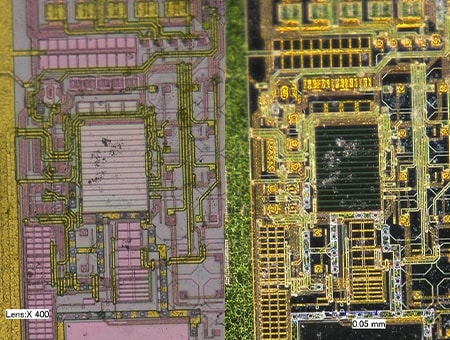
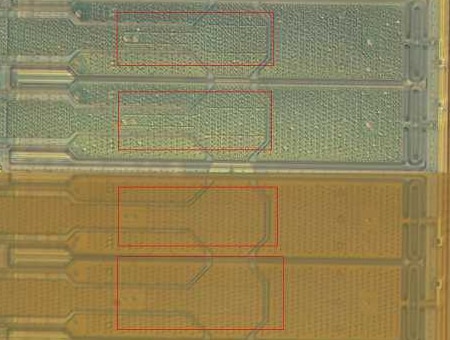
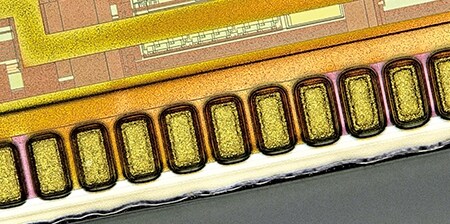
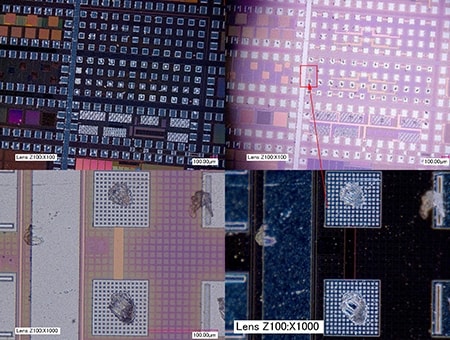
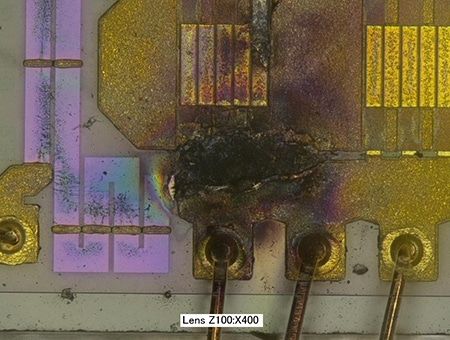
Prüfung und Analyse von in IC-Chips eingebundenen Fremdpartikeln
In Schaltkreisen eingebundene Fremdpartikel können Kurzschlüsse verursachen, die zu Bauteilausfällen und Defekten führen.
Das Digitalmikroskop der Modellreihe VHX erfasst klare Aufnahmen von Fremdkörpern bei hoher Vergrößerung. Mithilfe der 3D-Bildgebung, die mit einer begrenzten Anzahl von Aufnahmen durchgeführt werden kann, lassen sich Fremdpartikel von Unregelmäßigkeiten auf der Schaltkreisoberfläche unterscheiden.
Darüber hinaus ermöglicht die Modellreihe VHX 3D-Form- und Profilmessungen von Fremdkörpern mithilfe der Höheninformationen aus der 3D-Bildgebung. Mit nur einem System lassen sich alle Aufgaben von der quantitativen Beurteilung der Größe, Struktur und des Volumens eines Fremdpartikels bis hin zur Berichterstellung anhand von aufgenommenen Bildern und Messwerten schnell erledigen.

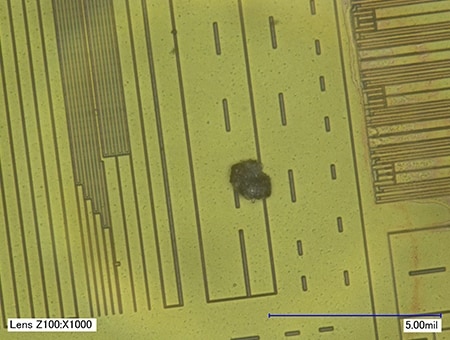


Verbesserte Genauigkeit und Arbeitseffizienz bei der Schadens- und Fehleranalyse von Leiterplatten
Dank des Digitalmikroskops der Modellreihe VHX, das 2D- und 3D-Messungen sowie Betrachtungen und Analysen mit klaren Aufnahmen mit nur einem System ermöglicht, ändern sich Genauigkeit und Arbeitseffizienz bei der Schadens- und Fehleranalyse von Leiterplatten erheblich, unabhängig von deren dreidimensionalen Strukturen.
Weiterführende Analysen und quantitative Beurteilungen können mit einfacher Bedienung durchgeführt werden, so dass benutzerunabhängige Ergebnisse erzielt werden.
Zusätzlich zu den hier vorgestellten Funktionen verfügt die Modellreihe VHX über viele weitere nützliche Funktionen für die Analyse verschiedener Fehler und Defekte, die bei unterschiedlichen Arten von Messobjekten auftreten können.
Für weitere Informationen zur Modellreihe VHX klicken Sie bitte auf die unten angezeigte Schaltfläche, um die Broschüre herunterzuladen. Für Anfragen klicken Sie bitte auf die entsprechende Schaltfläche, um KEYENCE zu kontaktieren.


